论文总字数:43895字
摘 要
离子注入剥离技术在宽禁带半导体异质结构制备中具有独特优势。本文通过SRIM软件对体GaN材料的氢离子注入情况进行了仿真。研究了常温下,将1.6Mev的高能氢离子注入到体GaN材料所引入的损伤和缺陷,高能氢离子注入后体GaN样品在700ºC、900ºC和1000ºC温度下退火15分钟后的剥离情况以及离子注入引入的损伤和缺陷的修复情况,其中氢离子注入剂量为1.0E17/cm²和2.0E17/cm²。通过光学显微镜、光透射测试仪、拉曼光谱测试仪、原子力显微镜、扫描电子显微镜和X射线衍射仪对退火前后的样品表征。结果表明,本文离子注入和退火条件下,GaN样品未能剥离,且GaN样品表面未出现相关文献所述起泡现象。随着氢离子注入剂量的增加,GaN样品内部引入的损伤和缺陷增多,适当温度下退火能修复部分损伤和缺陷,且退火温度高低与损伤和缺陷的修复正相关;过高的退火温度会使GaN样品表面形貌发生剧烈变化。综合实验和仿真结果,实现GaN样品的离子注入自支撑剥离需加大氢离子注入剂量,以补偿随注入深度增加而造成的氢离子中心浓度严重降低带来的影响。
关键词:离子注入剥离,半导体异质集成,氮化镓,宽禁带半导体
Investigation On Heterogeneous Integration Of Wide Band Gap Semiconductor Gallium Nitride And It’s Ion-cut Process
Abstract
There are unique advantages in the manufacture of hetero-structures of wide band gap semiconductors by using ion-cut method. The depth and distribution of implanted ions in bulk Gallium Nitride sample under different conditions are simulated by the software SRIM. The damage and defects inside the sample induced by the high energy hydrogen ions are studied before and after the annealing of the ion-implanted sample at 700ºC, 900ºC and 1000ºC for about 15 minutes, while the sample is implanted with 1.6MeV hydrogen ions at implantation temperatures of RT and the dose of the implanted ions are 1.0E17/cm² and 2.0E17/cm².
In addition, the characterization of the ion-implanted and annealed bulk Gallium Nitride sample has been performed through Optical Microscope, Optical Transmission, Atomic Force Microscope, Scanning Electron Microscope, Raman and X-ray Diffraction. The results show that the self-standing Gallium Nitride film can’t be released from the bulk Gallium Nitride under conditions above, and there is no observed surface blistering described in other thesis. With the dose of implanted ions increased, the sum of damage and defects inside the bulk Gallium Nitride increases. Some damage and defects will be repaired after annealed at an appropriate temperature while the annealing temperature is positively correlated with the level of repaired damage and defects. However, over temperature will dramatically change the sample’s surface morphology.
To achieve a self-standing Gallium Nitride film released from the bulk Gallium Nitride through ion-cut method, it is necessary to increase the implantation dose of hydrogen ions to compensate the decreased center concentration of implanted ions caused by the high implant energy.
Key Words: Ion-cut, Heterogeneous Integration of Semiconductor, Gallium Nitride, Wide Band Gap Semiconductor
目录
摘要 I
Abstract II
第一章 半导体异质集成 1
1.1 半导体异质集成概述 1
1.2半导体异质集成背景 1
1.3异质集成面临的挑战 2
1.4异质集成方案 3
1.4.1外延生长技术 3
1.4.2键合技术 4
1.4.3层转移技术 7
1.4.4离子注入剥离技术 8
第二章 宽禁带半导体的发展与应用 11
2.1碳化硅的发展及其应用 11
2.1.1硅基功率器件及其限制 11
2.1.2碳化硅技术的发展 12
2.1.3碳化硅功率器件 13
2.2氮化物的发展及其应用 14
2.2.1氮化物及其电子器件特性 15
2.2.2氮化物技术的发展 16
2.2.3氮化物的遗留问题与未来 18
2.3宽禁带半导体的掺杂 18
第三章 氮化镓的制备 20
3.1氮化镓材料概述 20
3.2 MOCVD和HVPE技术 21
3.2.1 MOCVD技术 21
3.2.2 HVPE技术 22
3.3 GaN异质外延生长 23
3.4 GaN横向外延生长 24
3.5 离子注入剥离GaN 25
第四章 GaN高能离子注入剥离与表征 28
4.1 离子注入仿真 28
4.2 离子注入与退火 30
4.3 离子注入与退火后的表征 31
4.3.1光学显微镜表征(Optical Microscope) 32
4.3.2光透射表征(Optical Transmission) 33
4.3.3原子力显微技术表征(Atomic Force Microscope) 34
4.3.4扫描电子显微镜表征(Scanning Electron Microscope) 35
4.3.5拉曼光谱表征(Raman) 36
4.3.6 X射线衍射表征(X Ray Diffraction) 37
第五章 总结与展望 38
5.1 总结 38
5.2 展望 39
致 谢 40
本科期间发表论文 41
参考文献 41
第一章 半导体异质集成
1.1 半导体异质集成概述
通常,在异质衬底上直接外延生长半导体材料需要遵守一系列严格的技术标准,其难以获得体材料品质的异质集成半导体材料,限制了异质集成半导体材料和柔性器件的自由设计与制造。定制化合物半导体并将其集成在异质衬底的技术将引领优质和新功能材料潮流,并对电子学、光电子学、自旋电子学、生物传感、光伏技术等众多领域产生潜在影响。
异质集成可通过多种技术实现,离子注入剥离技术(俗称“智能剥离技术”)是很有前景的一种。离子注入剥离技术包括将轻质离子注入到待剥离半导体,已注半导体与异质衬底的键合,并通过退火等过程使离子注入引入的缺陷层裂开,达到剥离目的。其中常用键合技术包括直接键合、阳极键合、金属键合、聚合物键合等;常用剥离技术包括离子剥离、化学剥离、物理剥离、激光剥离等。
离子注入剥离技术具有通用性,可应用于单晶层的剥离或从不同晶体精细转移单晶层。对于生长在适宜衬底上的给定功能材料,可通过离子注入剥离技术将其与异质衬底集成以提高器件或系统性能。该异质集成技术可替代直接沉积技术,并可实现晶圆级层转移,促使了一种异质半导体材料与微系统集成的新方法。
1.2半导体异质集成背景
半个世纪以来,减小器件尺寸一直是提高MOSFET性能最重要的手段。然而,不断缩小器件尺寸在未来将十分具有挑战性,2007年出版的国际半导体技术蓝图阐述了半导体行业面临的技术难题,并印证了不断缩小器件尺寸所遭受的技术瓶颈。例如,为了满足高度缩放的MOSFET在栅极长度小于10nm情况的性能和功率上的要求,准弹道操作和在源端增强热载流子的速度和注射是很有必要的。最终,在硅基上引入锗或化合物半导体沟道等新结构是必要的。
表1-1 部分未掺杂化合物半导体在300K时的基本特性:带隙能(),空穴迁移率(),电子迁移率(),杨氏模量(E),泊松比(σ)
材料 | E(GPa) | σ | |||
C | 5.46-5.6 | ≦1800 | ≦2200 | 1050 | 0.1 |
Si | 1.107 | ≦450 | ≦1400 | 130 | 0.28 |
Ge | 0.661 | ≦1900 | ≦3900 | 103 | 0.26 |
GaP | 2.261 | 120 | 200 | 103 | 1.1 |
GaAs | 1.428 | 420 | 8500 | 85.9 | 0.455 |
GaSb | 0.70 | 1400 | 7700 | 63.1 | 0.33 |
InP | 1.35 | 150 | 4500 | 61.1 | 0.7 |
InAs | 0.356 | 460 | 33000 | 51.4 | 0.26 |
InSb | 0.18 | 850 | 78000 | 40.9 | 0.18 |
GaN | 3.42 | ≦200 | ~1400 | 150 | 0.23 |
AlN | 6.2 | 14 | 300 | ~340 | ~0.2 |
如表1-1所示,与硅相比,几种化合物半导体大体上有更高的电子迁移率,这一现象激起了科研工作者开发去硅晶体管。1965起,GaAs作为第一种半导体化合物并用于制造MOSFET[1-3],几种化合物半导体如InP、GaAs、GaN和它们的三元、四元合金(InGaAs、InAlAs、AlGaN、InGaP、InGaAsN、AlGaAs和GaAsSb)、SiGe合金被用于制造异质结双极型晶体管[4-9]。除此以外,GaAs、GaN和InAs还因其较高的电子迁移率被用于制造高电子迁移率晶体管(HEMTs)。英特尔研究人员宣布实现基于InSb量子阱的GaAs基新型超高速晶体管[10, 11]。尽管几十年前科研人员就认识到化合物半导体相较于硅单晶有许多优势,直到2003年硅基化合物半导体器件才真正问世。这是因为研究人员发现将非硅材料掺入到互补金属氧化物半导体(CMOS)晶体管以提高其性能和增强其能量效率十分必要。
因为其属于间接禁带半导体,单晶硅作为发光源性能较弱。为了提高硅的发光效率,研究人员通过各种努力在纳米和量子尺寸上操作硅,并开发其非线性光学特性。但是,这些器件很难表现出超越自己化合物半导体的性能;目前,这些化合物半导体作为最前沿的光电器件活跃于世界电信市场。因此,通过结合化合物半导体光子器件技术和硅基集成电路技术来实现高效率的片上光源仍然是替代芯片外光源的重要选择。
剩余内容已隐藏,请支付后下载全文,论文总字数:43895字
相关图片展示:
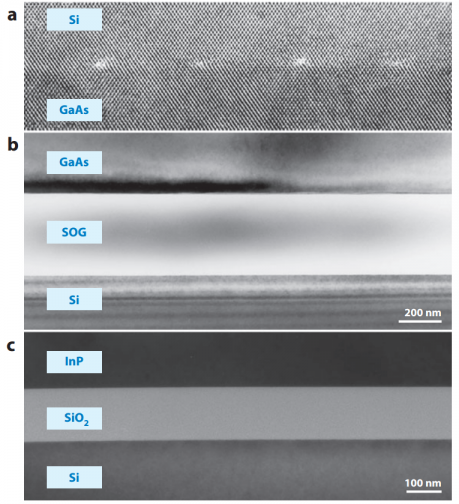
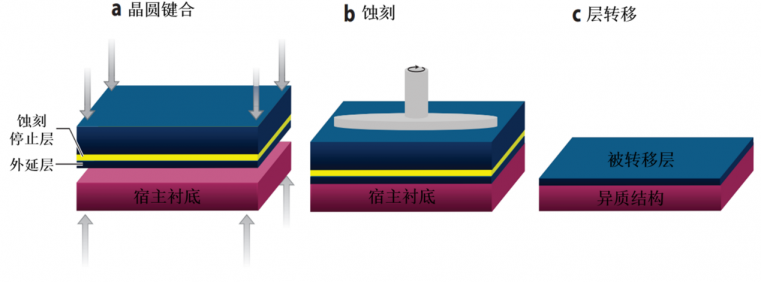
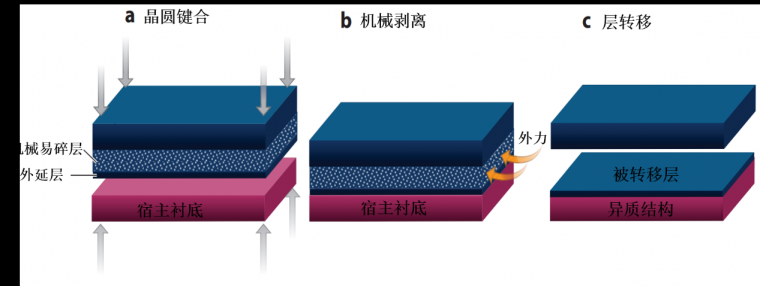
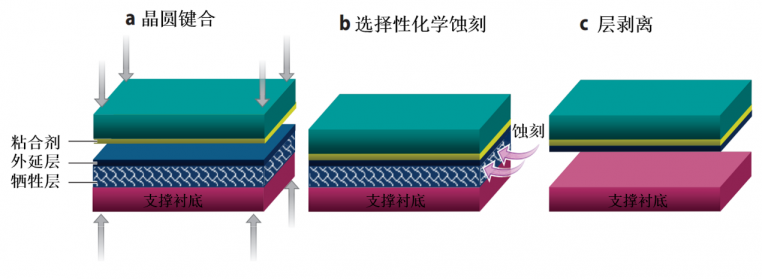
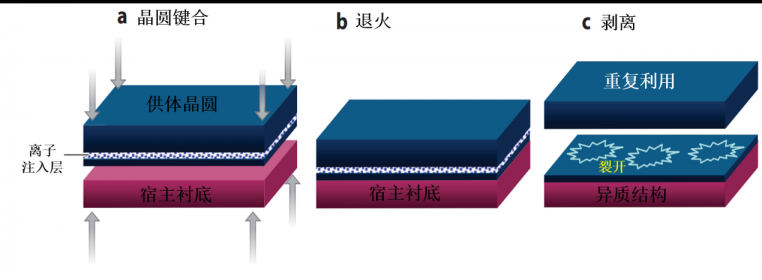
该课题毕业论文、开题报告、外文翻译、程序设计、图纸设计等资料可联系客服协助查找;


